
 | |
|
НПО Системы Безопасности (499)340-94-73 График работы: ПН-ПТ: 10:00-19:00 СБ-ВС: выходной  |
Главная » Периодика » Безопасность 01234 ... 22 Наибольшее распространение получил метод возбуждения при инжекции носителей через р-п переход. Рассмотрим это подробней. Инжекционное возбуждение самым простым образом можно объяснить на основе рассмотрения перехода типа p-i-n, энергетическая схема которого представлена на рис. 1.  Уровень/ Ферш Излучающие переходы ----Неизлушюш,ие переходы I I I \JlomoH , Энергии • e \ 0 проводимости Фоном Свет Примесный,- уровень I  Запрещён-ная зона ® © ® Валентная Л зона Рис. 1. Энергетическая схема перехода типа p-i-n. а - расположение энергетических зон и уровня Ферми диода структуры p-i-n; б - механизм рекомбинации в модели зон полупроводника (/ - переходы типа зона-зона, - переходы типа зона - примесный уровень. /Я - переход с возбуждением электрона в зоне проводимости). В идеальном полупроводнике при температуре абсолютного нуля валентная зона полностью занята электронами, а зона проводимости полностью свободна, и полупроводник является изолятором. Однако при температуре выше нуля вследствие теплового возбуждения часть валентных электронов переходит в зону проводимости; в валентной зоне при этом возникают свободные места - дырки. Термодинамическое равновесие характеризуется тем, что имеются равновесные концентрации основных носителей - дырок и электронов соответственно в областях р к п, которые способны рекомбинировать с носителями противоположного знака в случае инжекции последних извне. B случае с переходом типа р-г-п при приложении к нему напряжения в прямом направлении в зоне i появляются носители обоих знаков. Для рекомбинации этих носителей имеется несколько возможностей. При этом энергия от внешнего источника напряжения передается решетке полупроводника в виде тепловой или световой энергии. Потенциальный барьер между областями р и п снижается, и электроны из области п диффундируют в область объемного заряда (зона i на рис. 1,а) ив область р, создавая там избыточную (неравновесную) концентрацию. Аналогичным же образом возникает избыточная концентрация дырок в области п и слое объемного заряда. На рис. 1,6 на примере зонно-примесной структу-)ы полупроводника показаны основные явления при рекомбинации. 1СЛП электрон или дырка переходит из одной зоны в другую, то такая рекомбинация носит название межзонной или собственной (/ на рис. 1,6). Во втором случае (Я на рис. 1,6) переход осуществляется через примесный уровень. Такая рекомбинация называется примесной. Возможен и третий случай рекомбинации ( / на рис. 1,6). В результате межзонной или примесной рекомбинации при исчезновении пары (электрона и дырки) происходит выделение энергии, определяемой в первом случае шириной запрещенной зоны ЛЕв, а во втором - шириной .Л£п от зоны проводимости до примесного уровня. Энергия может выделяться в ви,де светового кванта <v=A£ !) или передаваться в виде тепла (фонона) кристаллической решетке. В третьем случае энергия рекомбинирующей пары передается третьему свободному носителю тока, который в дальнейшем передает полученную энергию в виде фонона. Переходы с выделением световых квантов называют излучатель-ными, а в случае выделения фононов - безызлучательными. Кроме того, различают прямые и непрямые излучательные переходы. В случае прямых переходов при рекомбинации электрона и дырки излучается только фотон, в случае же непрямого перехода в процессе рекомбинации, кроме появ.чения фотона, происходит испускание (или поглощение) фонона - кванта колебаний решетки кристалла. Вероятность межзонной излучательной рекомбинации при прямых переходах на несколько порядков выше вероятности при непрямых переходах. Вероятность излучательной рекомбинации возрастает также с увеличением ширины запрещенной зоны. Следует также отметить, что электроны и дырки в кристалле имеют массу, отличную от массы свободного электрона и называемую эффективной массой. Излучательная рекомбинация более вероятна в материалах с малой эффективной массой. Наилучшим сочетанием свойств, необходимых для излучательной рекомбинации, а следовательно, для создания эффективных инжекционных источников света, обладает арсенид галлия, чем, в частности, и объясняется тот факт, что первый лазерный диод был изготовлен именно из этого материала. В зависимости от числа инжектированных носителей по отношению к состоянию термодинамического равновесия в зоне проводимости происходит увеличение, а в валентной зоне уменьшение уровня населенности допустимых состояний. При малом уровне инжекции это отклонение может привести к спонтанным переходам, т. е. 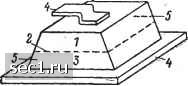 Рис. 2. Схематическое устройство полупроводникового ингкекционно- го лазера. / - полупроводник р-типа; 2 - р-п переход; 3 - полупроводник п-типа; 4 - контакты; 5 - плоскопаваллельные полированные грани. К люминесценции, а при большей инжекции, т. е. после достижения! инверсии населенности или, как иногда говорят, отрицательной температуры, - к лазерному эффекту (интенсивному, когерентному, монохроматическому высвечиванию с малым углом расходимости светового луча). Для получения лазерного эффекта в отличие от люминесценции к полупроводниковому устройству предъявляются следующие требования: 1) выравнивание заряда инжектированных носителей должно протекать в основном по излучательным оптическим переходам; 2) инжекция носителей должна быть достаточно большой, чтобы индуцированная эмиссия превосходипа индуцированную абсорбцию и были перекрыты неизбежные потери; 3) активная зона устройства должна находиться в объеме, резонансная частота которого соответствует спектральному интервалу, в котором возможно индуцированное излучение. Другими словами, для определенного! направления распространения света должна быть создана сильная обратная связь. Два первых условия в-основном обусловливаются свойствами материалов и определяют выбор полупроводников для изготовления диодов, а также величину тока накачки. Третье условие обеспечивается соответствующим конструктивно-геометрическим решением. Конструктивно прибор выполняется так, что при появлении излучения оно претерпевает многократное отражение от граней оптического резонатора, проходя через рабочий объем полупроводника, находящегося в состоянии инверсной населенности. Оптическое усиление на единицу длины в полупроводниках может быть в сотни и тысячи раз больше, чем в иных типах лазерных устройств. Поэтому даже очень короткая, составляющая в длину доли миллиметра оптическая дорожка, несмотря на низкий коэффициент отражения плоскопараллельных полированных граней (для арсенида галлия оо составляет примерно 35%), оказывается достаточной для перехода: к режиму генерации когерентного монохроматического света. Схематическое устройство полупроводникового лазера показано на рис. 2. Основные характеристики инжекционных излучательных диодов. Основными характеристиками полупроводниковых инжекционных источников света являются: спектральные характеристики, диаграмма направленности излучения, к. п. д. (эффективность преобразования электрической энергии в световую), временные (динамические) характеристики, мощность, а также хорошо известные и для обычных диодов вольт-амперные и вольт-емкостные характеристики. Для лазерных диодов, кроме того, важным параметром является пороговая плотность тока. Указанные параметры в значительной мере зависят от температуры рабочего кристалла диода. Некоторые лазерные диоды не 01234 ... 22 |